GP-PRO sf系列
实现高性价比
多品种、小批量生产的标准化设备

为满足少量生产具有高附加值产品的需求而开发的单个压机的小型全自动塑封设备“sf系列”。该系列有适用于生产单框架的sf40、生产双框架的sf120两种机型。
此设备性价比高、小巧且具有优秀的可维护性,能够满足顾客的多样需求。
特长1:单个压机设备带来的高性价比
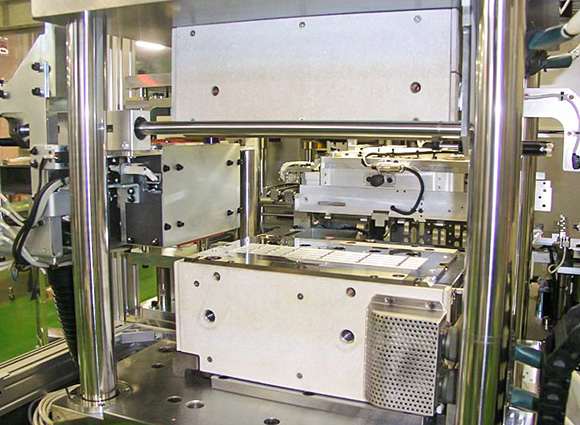
通过单个压机设备及独有的装载装置,实现了降低设备成本的自动塑封。最大可适用引线框架尺寸为75 mmx270 mm。
特长2:支持实现稳定生产的IoT
实现智能工厂所需的运转状态的实时可视化。(选项)
通过持续监控,可提前发出预警,避免设备电脑发生意外导致的中断风险。支持顾客的预防保全活动。
特长3:最优化的空间配置
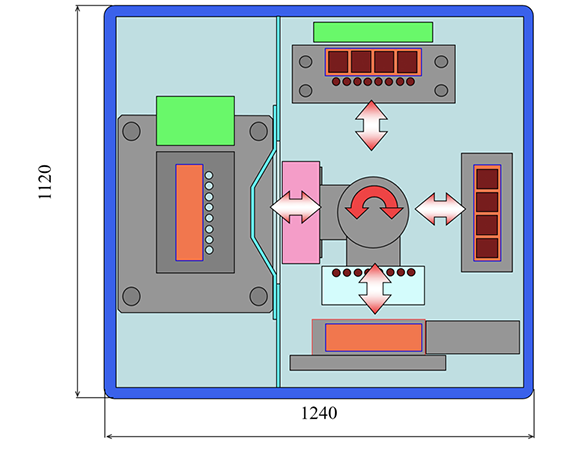
sf40是一台全自动塑封机,其占地面积只有1.4㎡(1240 mm x 1120 mm),节省了空间。
为了适用多品种的树脂,我们还提供可简单更换的树脂料盒。(选项)
特长4:广泛的标准配备
预热台

标准配备了可控预热时间的预热台。
带有旋转刷的强力模具除尘器
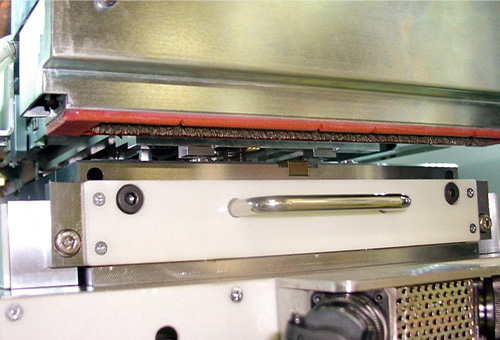
通过旋转刷卷起粉尘并将其吸除,
保证成型后的模具清洁。
保证成型后的模具清洁。
特长5:多种成型辅助选项
HFC(下模活动CAV装置)
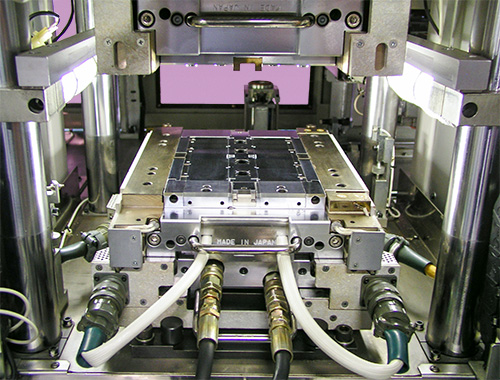
针对QFN和BGA产品,同一个HFC装置可适用于多种厚度的框架,也无需更换下模具。
VAM(型腔真空装置)
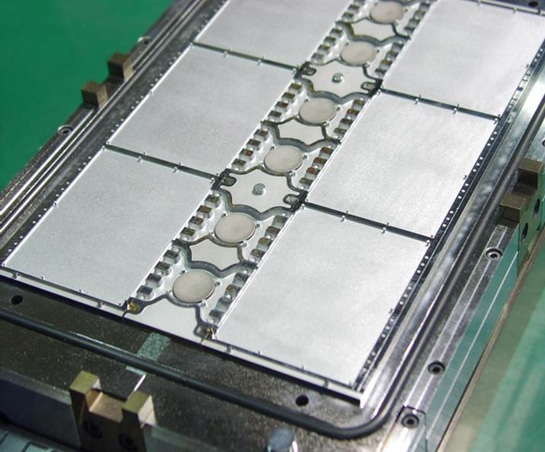
当遇到复杂的封装条件、注塑口设计及树脂特性的情况下,可通过型腔抽真空的方式来实现。
FAM(薄膜辅助装置)
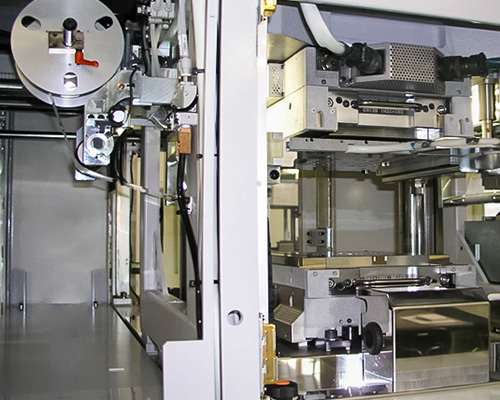
通过使用薄膜的FAM技术实现以芯片外露封装为代表的传感器成型和功率器件等的散热片外露成型。
设备规格
| Clamp Force | Model Name(press) | Machine Size(mm) | Weight | Max. L/F Size(mm) | |
|---|---|---|---|---|---|
| 120ton | GP-PRO sf120 | (1press) | W:1510×L:1350×H:1880 | 3.8ton | 75×270 |
| 40ton | GP-PRO sf40 | (1press) | W:1200×L:1100×H:1820 | 2.5ton | |
产品一览
半导体封装设备
-
GP-PRO SP系列
适用于大量生产的自动塑封系统。
为提高产品的可靠性,我们采取全面的防尘措施,满足从民用IC到车载IC和精密零件的广泛领域对高品质的需求。
-
GP-PRO sa系列
半自动塑封系统。
将引线框架和树脂自动传送到模具中,自动操作直至成型为止,
是然后手动取出产品。
-
GP-PRO LAB系列
为从开发到特殊应用提供各种齐全的选项的手动塑封系统。

-
S・Pot
使用小尺寸模具,操作简单,面向设备开发的台式小型成型机。
短时间、低价格实现试作生产,灵活应对新的封装开发。
-
GP塑封模具
封装半导体的精密模具。以本公司独有的CCFC为首的各种封装技术,对应各种封装形式。

